相关新闻

2025.07.07
“芯”火闪耀,未来可“碁”——2025届校招生入职集训
2025.06.30
1991金沙CC官方十周年:感恩同行,共启新程
2025.06.30
MAS 6P 封装载板 LDI 设备成功通过头部客户验收
2025.06.24
Au-Au 键合在 MEMS 领域的应用
Au-Au 键合在 MEMS 领域的应用
发布时间:
2025-06-24

阅读



Au-Au 键合(Au-Au bonding/金金键合)在 MEMS 领域中是一种常见的晶圆键合技术,主要用于实现微器件之间的封装、电互连或结构连接。由于金具有优良的导电性、化学稳定性和抗氧化能力,Au-Au 键合在高性能、高可靠性 MEMS 器件的制造中具有重要应用价值。
Au-Au 键合是将两个镀有金层的表面,在一定温度和压力条件下直接进行键合的一种同种材料扩散键合技术。它的原理基于固相扩散过程:在加热和加压条件下,两个金表面接触后,原子在界面上发生扩散,形成原子级连接。最终形成机械强度高、电性能优的结合层。

MEMS 器件,如惯性传感器、压力传感器、RF MEMS等通常需要真空或受控气氛环境以保障性能。Au-Au 键合因其优异的密封性和抗腐蚀能力,成为气密性封装的优选工艺。
例如,博世(Bosch)在 MEMS 加速度计和陀螺仪的应用中便采用了Au-Au 键合,以确保器件长期稳定运行。Au-Au 键合具有低电阻、高导电性和优异的抗电迁移性能,适用于高频 RF MEMS,如5G射频滤波器、毫米波天线等和功率 MEMS,如 MEMS 继电器等。在 CMOS-MEMS 集成中,Au-Au 键合可实现晶圆级互连,减少封装尺寸并提升信号完整性。 Au-Au 键合可承受高温(>300°C)和机械应力,适用于汽车电子、航空航天等严苛环境下的 MEMS 器件。
案例学习 Au-Au 键合及其流片测试结果
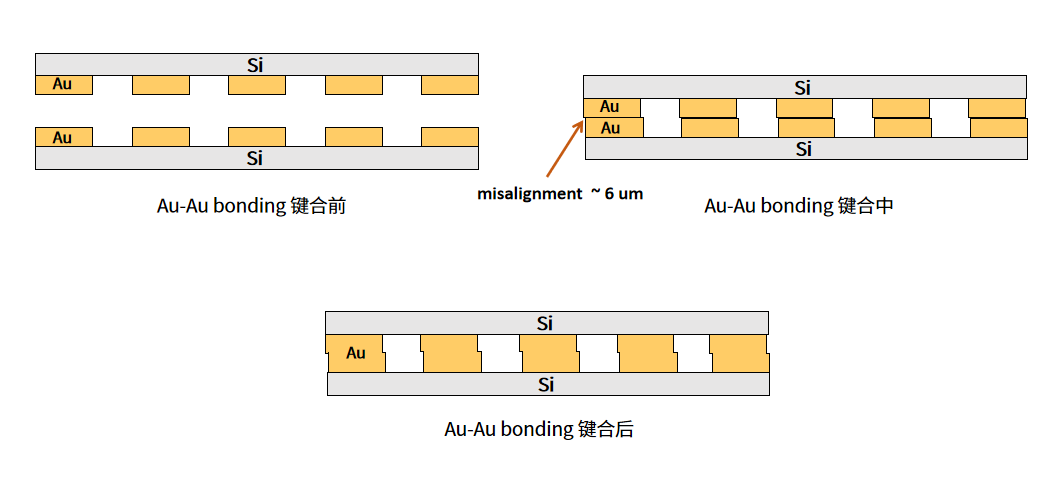
Au-Au 键合截面
通过使用CFMEE WB 8 晶圆键合机的 Au-Au 键合配方,自动执行热压键合流程,在高温高压的条件下保持足够长的键合时间,冷却至室温后取出晶圆。在这之后,通过晶圆划片机将键合后晶圆切成数个5x5mm的芯片。为了能在SEM(扫描电子显微镜)下观察到键合界面,需要置样处理芯片。通过下图能够清晰地看到金金热压键合截面的实际键合效果,SEM测试显示金金界面完全融合,原子级扩散充分,形成了机械强度高、电性能优的结合层,验证了良好的热压键合质量。
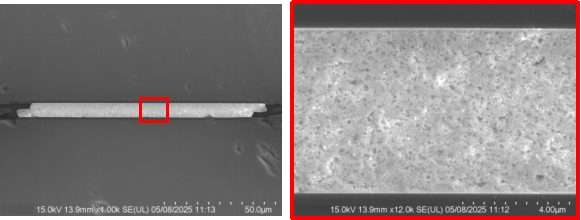
CFMEE 晶圆对准键合解决方案
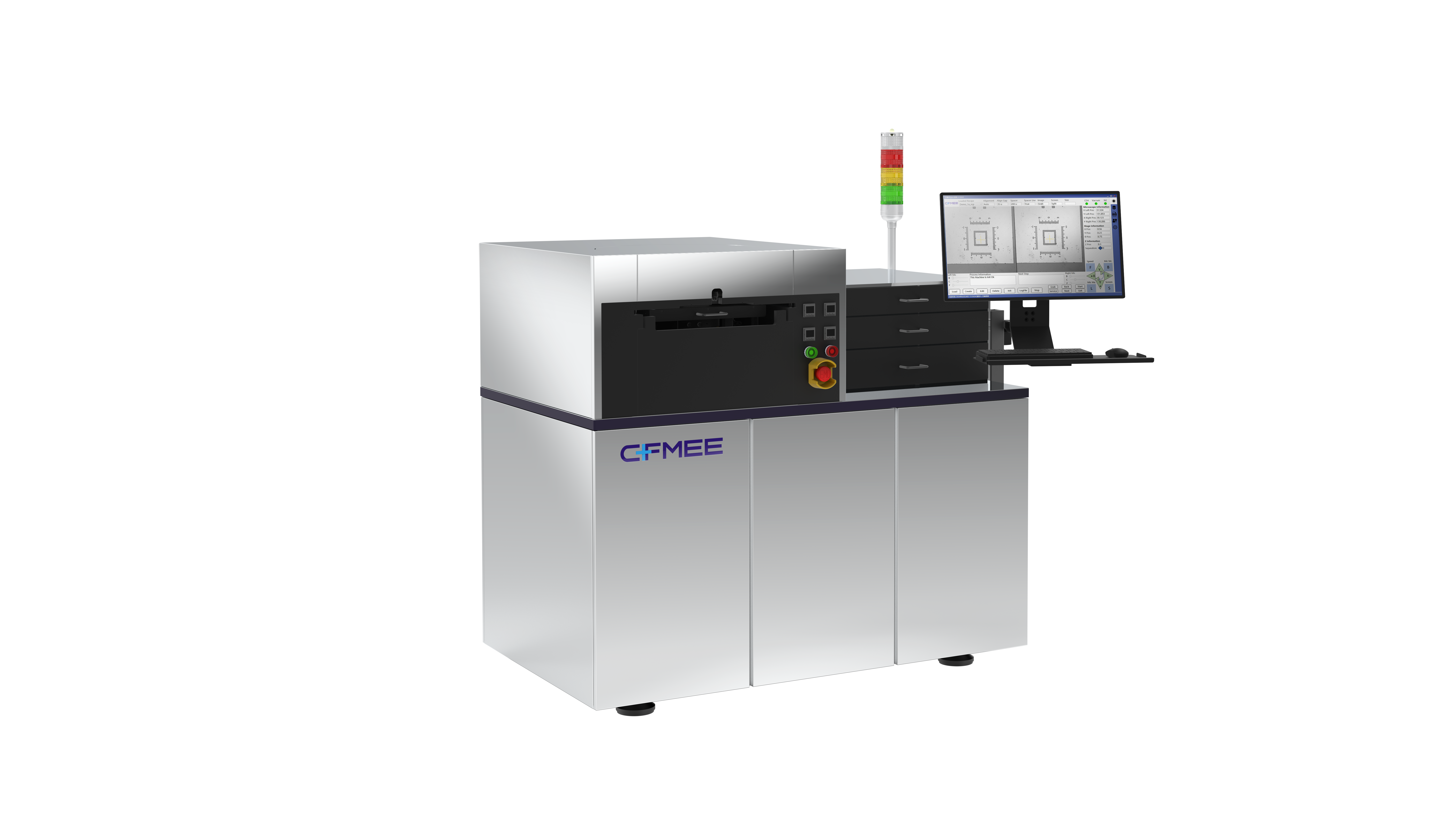

WA 8
WB 8
CFMEE WA 8晶圆对准机支持亚微米级对准,适用于MEMS器件的精密键合。WA 8晶圆对准机搭载光学对准系统可确保金层图案的精确匹配,以减少对准后的偏移量。将装载已对准后的晶圆堆的夹具移入CFMEE WB 8 晶圆键合机后执行热压键合程式,键合后偏移稳定控制在6微米内(金金扩散键合工艺)。
Au-Au 键合通常需高温(200-400°C)和高压(10-100kN),CFMEE WB 8键合机采用模块化设计,支持可调温控和压力均匀性(±1%)。键合系统提供高达100kN的键合力,适用于4/6/8英寸晶圆的热压键合工艺。Au-Au 键合较长的键合时间需要设备极高的高压高温稳定性以确保键合质量,这些都能够通过使用CFMEE WB 8 晶圆键合设备实现。除此之外,CFMEE WB 8 支持高真空或惰性气体环境以提升键合质量,可适用于需要真空封装的MEMS器件。
结论
Au-Au 键合作为一种高性能MEMS封装和互连技术,凭借其优异的物理与电学特性,广泛应用于对气密性、导电性和可靠性要求高的MEMS器件。配合使用CFMEE WA 8和WB 8晶圆键合设备,即可实现高精度、高质量的晶圆级Au-Au键合工艺。
返回列表


